
為持續提升企業價值,欣興電子積極參考並參與制定國際產業之技術藍圖,以因應各種未來產品的需求,並透過「專利佈局」、「技術發展」及「技術合作」三大策略,積極投入環保與低成本製程,建立以技術創新、智權自主為核心的產業,以創新突破,開拓新商機。

為鞏固欣興電子在市場上技術領先的地位,我們制定「創新技術保護、專利樹木建置、專利地圖整編」三大專利管理策略,進一步規劃未來專利佈局,提升公司的價值與競爭力,並積極研發異質整合(Heterogeneous Integration)相關技術,同時亦申請多國專利以保護公司技術資產。
欣興電子透過內部專利申請系統工具來保護研發成果,進一步掌握我們與客戶、供應商之間的研發成果,並持有專利,透過專利佈局提升價值及競爭力,在知識經濟的時代,穩固欣興電子於市場中的領導定位。
| 區域 | 項目 | 2019年 | 2020年 | 2021年 | 2022年 |
|---|---|---|---|---|---|
| 台灣 | 專利申請數量 | 34 | 48 | 62 | 56 |
| 專利獲証數量 | 32 | 34 | 57 | 61 | |
| 美國 | 專利申請數量 | 39 | 41 | 50 | 55 |
| 專利獲証數量 | 21 | 31 | 33 | 38 | |
| 中國大陸 | 專利申請數量 | 30 | 45 | 50 | 59 |
| 專利獲証數量 | 19 | 24 | 45 | 40 | |
| 其他 | 專利申請數量 | 0 | 2 | 0 | 0 |
| 專利獲証數量 | 7 | 8 | 3 | 0 |
欣興電子本著立足台灣、佈局全球的策略,將研發據點設於台灣桃園及新竹,包含新建的楊梅廠與改制的山鶯二廠,針對客戶需求之技術與未來三至五年之前瞻創新技術,致力投入發展不同的創新研發主軸,除引進先進設備及網羅產業優秀研發人才外,欣興電子也投入大量研發經費,目前台灣廠區每年投入研發經費為當年度營收1%,近年投入的研發經費逐年成長,以因應各種未來產品的需求,來創造技術的專利性、領先性、穩定性。並積極投入環保與高階製程,建立以技術創新、智權自主為核心的產業。
| 年度 | 2019年 | 2020年 | 2021年 | 2022年 |
|---|---|---|---|---|
| 研發費用(億元) | 6.48 | 9.79 | 11.06 | 15.84 |
| 佔比(%) | 0.8 | 1.1 | 1.1 | 1.1 |
欣興電子因應未來重大的產業趨勢,持續投入研發能量,深耕高階產品技術平台,如5G高頻高速印刷電路板產品、超小間距LED模組開發、Cool PCB高導熱效能模組開發、NF(Nick -Free surface finished)新技術開發以及高階微顯盲孔電路板新技術開發。
現階段面對第5G行動通訊進入全球商用階段,欣興電子聚焦於包括智慧型手機/平板電腦高密度板(Smart Phone/NB HDI)產品,天線封裝基板高頻電路板、雷達板與陣列天線,光模塊的光電通訊板,以及包含各種伺服器交換機與路由器的高層數電路板(High Layer Count)高速電路板等四大研發領域。印刷電路板核心技術開發包括mSAP(L/S=18/22 µm)細線路製程、內埋式銅鑲嵌(Cu inlay)高散熱技術、同軸貫通孔(Coaxial via)低能量耗損技術、板厚5.4mm高縱橫比(32:1)機鑽及鍍銅技術。
欣興電子憑藉於印刷電路板/IC載板之大面板製造專業經驗,搭配固有之無核心板技術,平台創新多層膜佈線技術為基礎,整合半導體及面板產業之材料與設備業者組成研發聯盟,發展RDL first(Die last),超微細線路(2µm/2µm 線寬/線距)之面板級扇出型(Panel-level Fan-Out,PFO)先進封裝技術,以突破扇出型面板級封裝(Fan-Out Panel Level Package,FOPLP)之產業問題與技術挑戰,帶動整體產業鏈發展。另外因應未來高密度多功能晶片系統化之趨勢,欣興電子朝多晶片異質整合封裝技術平台開發,將來封裝尺寸也將由現行20mm x 20mm擴展至55mm x 55mm。
內埋線路載板(Embedded Trace Substrate,ETS)技術,在精載一廠重建規劃中導入新設備與藥水研究,強化上下料搬運方式與FM管控,提升L/S= 6/8μm良率至客戶認證水準。同時也與VIP客戶展開L/S=5/5μm平台先期開發,搭配多種乾膜與曝光機,以及表面處理藥水做測試,為下一個通訊世代奠定基礎。
| 項目 | 2022年與前一年度之技術創新 |
|---|---|
| 超微細線路之先進封裝技術 | 完成複合基板技術平台(RDL+HDI,RDL+BGA)及可靠度驗證,同時也完成多晶片異質整合封裝於複合機板上,裝尺寸由20mm x 20mm擴展至>55 mm x 55 mm,重佈線路層(Redistribution Layer,RDL)層數為5層,最小線寬可達2µm |
| 內埋線路載板新技術開發 | 因應2 nm以下晶片節點,高密度封裝互連需求,與供應商合作開發在L/S 5/5 um平台加入Cu pillar與防焊薄化製程,於Bump pad上製作外露於防焊層高度約4~10 um的Cu Pillar |
| 混合銅鑲嵌技術開發 | 銅塊厚度0.2~2mm,尺寸 < 6x15mm內埋技術開發 |

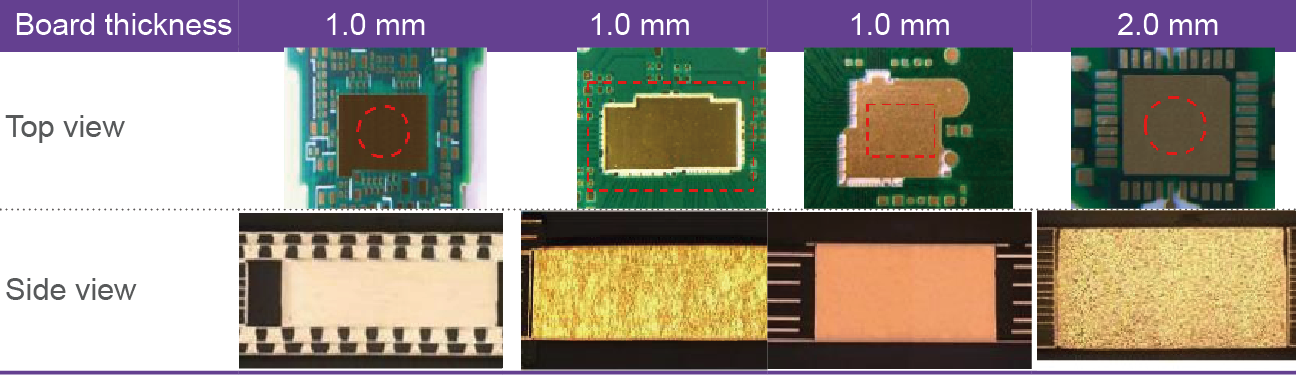
混和型銅塊(Hybrid Cu Inlay) |
內埋線路載板細線路新技術開發(加入Cu Pillar與防焊薄化) |
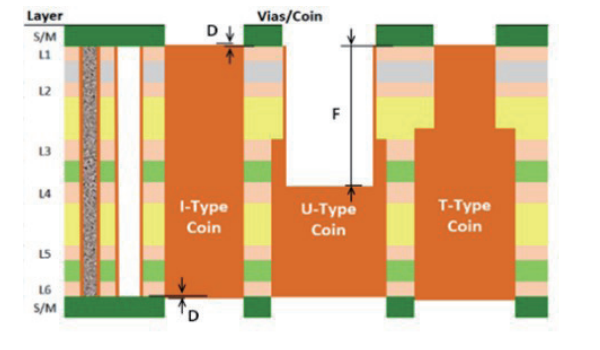
|
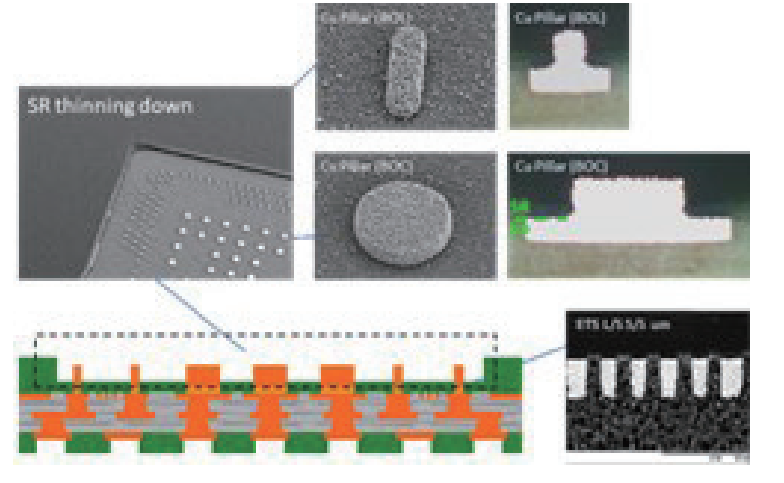
|
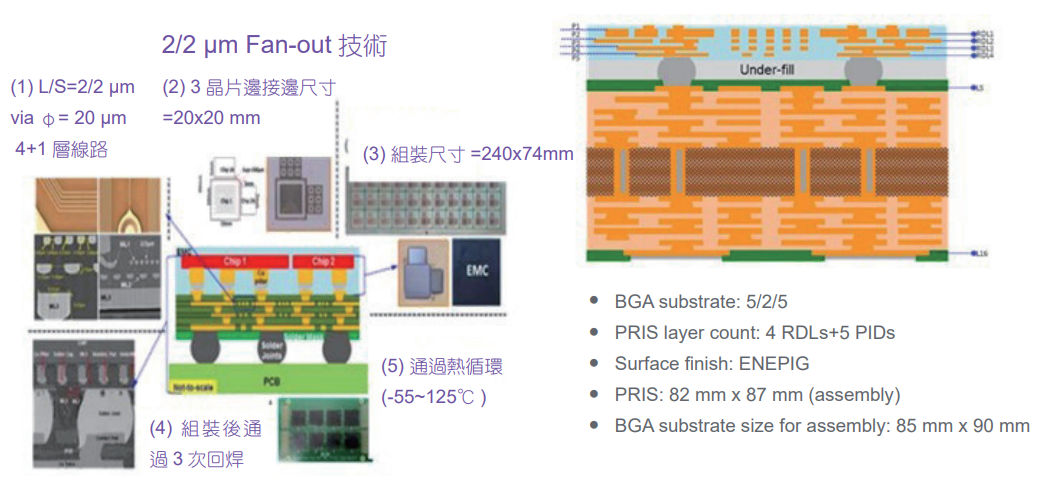
欣興電子深知以價值鏈合作帶動產業邁向永續創新的重要性,除與國際大廠客戶合作開發新一世代高階IC載板,與客戶交流,同步了解客戶對技術及下世代產品的需求,掌握客戶未來產品的開發藍圖外,並強化國內產業跨領域合作、開創自主產業及設備產品、強化產學研之研發關係、促使並推動業界訂定新規格,持續以最佳品質與服務模式滿足客戶期望,帶領整體產業鏈不斷向前邁進,拓展更寬廣之價值。
| 強化我國產業之跨領域合作 | AIoT與5G驅動多元產業應用,需要更高階的異質整合技術才能滿足性能需求,現在全球半導體業者都在加速發展於異質晶片整合製程。2025年將步入2nm 先進晶圓節點,基板互連間距將≦40µm,將需要更多系統單封裝(System-In-Package,SiP)、小晶片和異質整合封裝。欣興電子可為IC載板提供支援先進基板的異質整合平台,2021年導入多晶片異質整合封裝技術平台開發,封裝尺寸由20mm x 20mm,2022年後逐年擴展至55mm x 55mm。 |
| 開創我國自主產業及設備產品 |
2020年上半年新冠肺炎疫情影響,各國強制採取出入境管制對全球供應鏈造成強烈衝擊。另一方面,因應氣候變遷風險,世界各國淨零排放目標紛紛確立,已衍生而出資通訊大廠要求供應鏈配合100%使用綠能的國際再生能源倡議(RE100)。隨之而來的碳權與碳稅將會影響廠商設廠區位,供應商若沒有發展明確減碳策略,未來將被產業鏈逐漸淘汰。全球產業鏈將由過往的地理位置及貿易成本的連結,改由環境價值及國安成本的連結。 在半導體產業有許多大規模公司皆採用來自日韓以及歐美幾家大廠,欣興電子已與設備商(例如鍍銅線、蝕刻線)及材料廠商(例如5G基板、防焊材料商)合作加速研發,開發設備及材料相關的低碳技術,累積自主的研發創新量能,因應氣候變遷造成的市場風險,強化欣興電子產品的市場競爭力。 |
| 強化我國產學研之新研發關係 | 因應紅色供應鏈的崛起,以及材料、設備的在地化,公司採取與產學研三方共同開發的模式,加強投入開發新技術、新設備之計畫;如與學術機構共同開發雷射清潔新技術、AI檢測技術等,與設備商共同開發自對位Pick & Place新設備。另外我們與大學機電學院合作,共同開發新產品,由學校設計測試線路,公司製作與電性測試,將研發成果透過客戶的管道,進行新產品封測實際驗證,開創新的產品藍海。 |
| 促使業界訂定新規格 | 5G高速高頻應用之平台開發計畫、先進基板的異質整合IC載板平台與高階Micro-LED載板與光電模組、雷達天線模組,都是全新的計畫,業界尚未訂定出一套品質認證規格或測試的標準。欣興電子會根據客戶的開發時程,持續投入開發能量,以達到率先通過客戶認證之目標,成為業界這個技術平台的標竿,促使業界將此技術平台訂為業界的標準流程。2022年在雷達天線模組方面與客戶合作,並在台灣電路板產業國際展覽會(TPCA)展出。 |
| 合作內容 | 效益 | |
|---|---|---|
|
|
我們持續與世界級材料及設備供應商保持密切合作,並與國內設備商合作,引進高功能材料與尖端設備於新產品研發。尤其是現在5G高頻高速通訊,高頻低訊號損失的Low Df材料製程開發,更須要提早與材料供應商合作,取得技術領先。 | 全球供應鏈市場競爭激烈,欣興電子與供應商共同開發的成果,幫助欣興電子提前取得未來關鍵技術,保持業界的領先地位。同時有助於確保台灣相關產業在高度競爭趨勢下,能持續屹立不搖於各國自主化、集團化之產業鏈當中,進而取得關鍵位階。 |
|
|
欣興電子透過產學合作的方式,提供一個強化我國產學研之新研發關係,我們長期以來與國內大學如台灣大學、清華大學、中央大學、元智大學等學校有長期合作計畫,總經費為2,295萬元。希望藉此能有效運用學術界的研究成果、活絡國內學研單位的研究能量、鼓勵跨領域的基礎科學研究,以縮短公司研發的學習曲線,同時也幫學校培育將來的科技菁英。 欣興電子也有加入德國IZM及美國喬治亞理工學院發起之系統封裝技術研發聯盟,進行數項新產品與新技術的共同開發。 |
結合學術理論及產業生產與開發實務的共同合作,可以迅速縮短理論與實務的差異程度,讓先進的學術研究成果有效的與產業技術領域無縫接軌。另外產學合作強調的是整體性合作規劃,範圍包含師資、設備交流、研究生的訓練、經費資助。在各學術單位的法規下自主經營研究環境,能使學術界取得合理的利潤,也吸引更優秀的學術團隊加入研發,形成良性循環。 |
|
|
爭取來自政府在研發上的稅務減免、設備之投資抵減及獎勵、業界科專補助,以及研發投資抵減。欣興電子根據政府的重點輔導項目,提出相對應的新技術開發計畫、申請業界科專補助。 | 政府資金挹注加速欣興電子技術發展,強化產品競爭力,如「Panel-level超微細線路Fan-out」技術導入多晶片異質整合封裝技術平台開發,擴大封裝尺寸,將應用在5G高頻高速通訊,提高電性性能。另一方面,政府透過此合作關係,可以實際掌握國內產業界的研發潛能與發展的困境,作為將來擬定科技發展政策的依據。 |