技術發展
了解客戶的需求,市場的脈動
不斷創新研發,成為世界級公司是我們不斷的努力方向。致力於開發並提供符合甚至超越客戶現在及下一代需求之先進技術是我們一貫的目標。參考或參與制定國際PCB產業之技術藍圖(Technology Roadmap),因應各種未來產品的需求,快速切入下一波先進製造技術的開發,來創造技術的專利性、領先性、穩定性,從而維持及強化競爭力及客戶的滿意。同時積極投入環保與低成本製程,建立以技術創新、智權自主為核心的產業。
PCB SBU研發製程技術簡述如下:
微細線路(Fine line process)、Low Dk/Df 極薄介層材料開發、金屬填孔技術(Copper filled via),另外還有新創技術的PCB產品,各產品的專利數量與技術能力,皆居於世界領導地位。
IC載板SBU研發製程技術簡述如下:
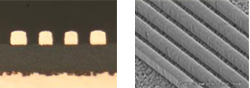
微細線路66
SAP技術實際量產能力為L/S = 9/12 μm,而7/8 μm platform 進行樣品認證中且朝超細線路L/S = 4/6 μm之開發。 ETS 10/10 μm 線路能力已達量產能力,5/5 μm 能力目前開發中;MESA技術L/S = 20/20 μm 已量產,L/S : 17/17 μm樣品階段,PSAP技術L/S = 9/12 μm樣品階段,L/S = 12/12 μm 已量產。
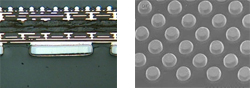
Fine bump 技術
為了因應細凸塊間距(Fine Bump Pitch)之需求己開發完成fine pitch uball 技術並開始穩定量產FCBGA 110μm Bump Pitch之產品,90μm & 100μm bump pitch 也持續出貨認證中 ,並己著手開發應用於FCCSP產品及FCBGA 80μm及以下 Bump Pitch Cu pillar 之產品。

Coreless技術
Coreless除提供了多層板超薄封裝厚度之優點外,並在電性表現上明顯優於傳統以Core為基礎的結構平台,目前2~3層coreless平台已通過認證並導入量產,另外4層或5+1B,6+1B等高彈性的疊構變化都可提供對應之樣品產品供測試認證。


